电话:15301560529

为成就您的产品,而努力
Work hard to make your product
案例展示


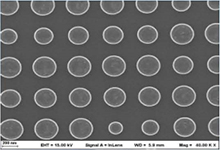

纳米线@PMMA CD 8nm 二维光栅 with CD 50nm 变直径纳米盘 误差±5nm Φ100um 光波导 线宽700nm
 公安备案号:苏公网安备32059002006658号
公安备案号:苏公网安备32059002006658号
 微特云办公系统 微纳制造 MEMS设计
微特云办公系统 微纳制造 MEMS设计