电话:15301560529

为成就您的产品,而努力
Work hard to make your product
案例展示
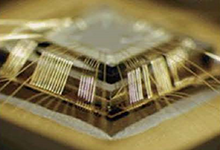
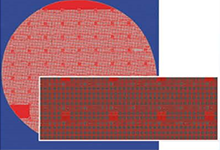
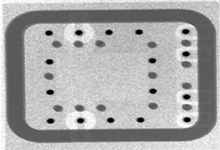
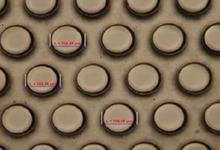
底层管芯与顶层管芯堆叠连接 Cu-Cu Metal Diffusion Bond TSV(Cu&Sn键合)Process Ultra High Density TGV For MEMS
 公安备案号:苏公网安备32059002006658号
公安备案号:苏公网安备32059002006658号
 微特云办公系统 微纳制造 MEMS设计
微特云办公系统 微纳制造 MEMS设计