
新闻
News
ICP刻蚀的基本要求
点击量:1312 日期:2023-07-24 编辑:硅时代
刻蚀中还存在负载效应,即发生刻蚀速率变慢的情况。分为宏观负载效应和微观负载效应。刻蚀面积很大时,因为气体传输受限和刻蚀气体耗尽,刻蚀速率会较慢,这称为宏观负载效应。在微细图形的局部区域内, 被刻蚀材料的密度过高造成刻蚀气体耗尽的情况称为微观负载效应。
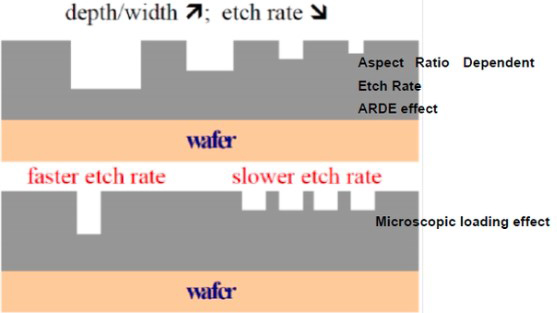
(2)图形保真度
设横向刻蚀速率为V1,纵向刻蚀速率为V2,通常用A 表示刻蚀的各向异性刻蚀的程度,定义如下:

A=1,表示图形转移中没有失真, 刻蚀具有很好的各向异性。A=0,图形失真情况严重,刻蚀为各向同性。
(3)均匀性
在材料制备时, 薄膜厚度一般有一定的不均匀性, 而刻蚀时同一衬底片的不同位置的刻蚀速率也不同。这些都会造成图形转移的不均匀。
刻蚀的均匀性在很大程度上依赖于设备的硬件参数, 如反应室的设置, 气流, 离子浓度等均匀性情况。其次是工艺参数的影响。
对于大衬底的刻蚀, 如果刻蚀时间不够, 膜厚处没有刻蚀完全;但是刻蚀时间太长,膜薄处会造成过刻蚀,实际情况中需要综合考虑。也可以在被刻蚀材料的下层制备截止层,截止层选用和被刻蚀材料有很高选择比的材料, 这样可以加长刻蚀时间, 保证膜厚处被刻蚀干净,膜薄处也不会造成明显的过刻蚀。
除了同一样片不同位置的均匀性问题, 同一刻蚀条件不同样片的刻蚀均匀性(也称重复性)也很重要。重复性与反应室的状况有很大的关联性。
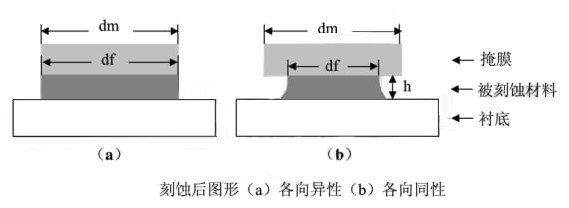
(4)表面形貌
一般情况下, 刻蚀后的表面形貌都希望侧壁陡直光滑, 刻蚀地面平滑。但对于不同的器件有时也有特殊要求,如需倾斜剖面、微透镜结构等。
(5)刻蚀的清洁
刻蚀中防止玷污是非常重要的。如果在接触孔的位置出现重金属沾污也会造成漏电。对于干法刻蚀,刻蚀表面还会出现聚合物的再淀积。
 公安备案号:苏公网安备32059002006658号
公安备案号:苏公网安备32059002006658号
 微特云办公系统 微纳制造 MEMS设计
微特云办公系统 微纳制造 MEMS设计