
新闻
News
磁控靶溅射沉积率的影响因素
点击量:599 日期:2023-07-31 编辑:硅时代
溅射沉积率是表征成膜速度的参数,其沉积率高低除了与工作气体的种类与压力、靶材种类与“溅射刻蚀区“的面积大小、靶面温度与靶面磁场强度、靶源与基片的间距等影响因素外,还受靶面的功率密度,亦即靶电源输出的“溅射电压与电流”两个重要因素的直接影响。
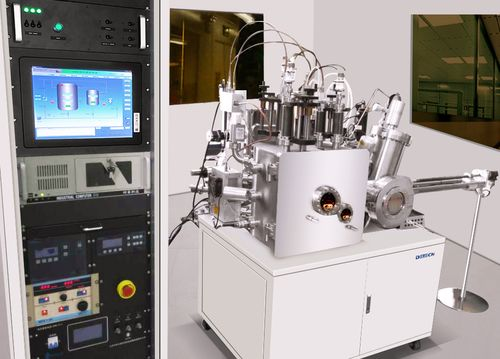
1、溅射电压与沉积率
在磁控靶前磁场控制区域间的等离子体越强烈和密集,靶材上的原子脱离率就越高。在影响溅射系数的诸因数中,当靶材、溅射气体等业已选定之后,比较起作用的就是磁控靶的放电电压。一般来说,在磁控溅射正常工艺范围内,放电电压越高,磁控靶的溅射系数就越大;也就是说入射离子的能量越大,溅射系数也越大。在溅射沉积所需的能量范围内,其影响是缓和的和渐变的。
2、溅射电流与沉积率
磁控靶的溅射电流与靶面离子流成正比,因此对沉积率的影响比电压要大得多。增加溅射电流的办法有两个:一个是提高工作电压;另一个是适当提高工作气体压力。沉积速率对应有一个最佳气压值,在该气体压力下,其相对沉积率最大,这个现象是磁控溅射的共同规律。在不影响膜层质量或满足用户要求的前提下,由溅射产额来考虑气体压力的最佳值是比较合适的。
3、溅射功率与沉积率
一般来说,磁控靶的溅射功率增高时,薄膜的沉积率速率也会变大;这里有一个先决条件,就是:加在磁控靶的溅射电压足够高,使工作气体离子在阴-阳极间电场中获得的能量,足以大过靶材的“溅射能量阀值”。有的时候,磁控靶的溅射电压很低(例如2百多伏),溅射电流也比较高,虽然平均溅射功率不低,却会出现靶材离子溅射出不来,不能发生溅射沉积成膜的情况。记录磁控靶的溅射电压和溅射电流数据,不但可以知道磁控靶的“溅射功率”,而且还可以大致了解轰击靶面离子的能量的高低和正确估计靶材离子的沉积状况,对分析很多真空镀膜中的问题和现象都会有帮助。
 公安备案号:苏公网安备32059002006658号
公安备案号:苏公网安备32059002006658号
 微特云办公系统 微纳制造 MEMS设计
微特云办公系统 微纳制造 MEMS设计