电话:15301560529

新闻
News
刻蚀偏差 (Etch Bias)
点击量:1045 日期:2023-08-22 编辑:硅时代
刻蚀偏差是指刻蚀以后线宽或关键尺寸间距的变化(见图1)。它通常是由于横向钻刻引起的(见图2),但也能由刻蚀剖面引起。当刻蚀中要去除掩模下过量的材料时,会引起被刻蚀材料的表面向光刻胶边缘凹进去,这样就会产生横向钻刻。计算刻蚀偏差的公式如下:
刻蚀偏差=Wb-Wa
其中,Wb=刻蚀前光刻胶的线宽
Wa=光刻胶去掉后被刻蚀材料的线宽
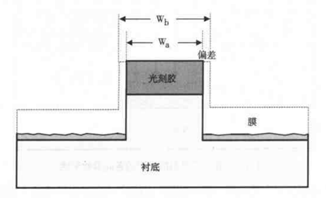
图1 刻蚀偏差

图2 刻蚀中的横向钻刻和倾斜
刻蚀偏差的大小与很多因素有关:衬底材料、光刻胶上图形的线宽、刻蚀工艺的参数等。目前额做法是对版图上所有的边缘添加(或减去)一个固定的线宽,被称为全片刻蚀偏差(global etch bias)。显然,这样的做法比较粗糙,设有顾及刻蚀偏差是与光刻胶上的线宽有关的。精确地做法是,建立一个刻蚀的模型,首先对设计的版图做修正;然后,在做光刻的OPC修正,如图2(第七章光刻邻近效应修正与计算光刻 P359 图7.40)所示。刻蚀修正可以使用模型,也可以是一些规则(类似于rules-based OPC)。也有尝试把刻蚀修正与光学修正合成在一起的。

图2 先做刻蚀修正,再做OPC修正的流程图
 公安备案号:苏公网安备32059002006658号
公安备案号:苏公网安备32059002006658号
 微特云办公系统 微纳制造 MEMS设计
微特云办公系统 微纳制造 MEMS设计