
新闻
News
实现高精度深硅刻蚀的方法
点击量:2015 日期:2023-09-14 编辑:硅时代
深反应离子刻蚀工艺,是实现高深宽比特性的重要方式,已成为微加工技术的基石。这项刻蚀技术在众多领域均得到了应用:1)MEMS电容式惯性传感器;2) 宏观设备的微型化;3) 三维集成电路堆叠技术的硅通孔工艺。
对于惯性MEMS传感器,有研究发现制备的电容式加速度计具有高深宽比结构能够显著增加传感面积,提供更高的验证质量并降低弹簧刚度,从而提高电容灵敏度。在三维集成电路封装领域,在单个基板上通过垂直互联的多个芯片可以显著提高设备性能降低尺寸,对于相同直径的通孔结构,深宽比越大越有助于解决热耗散和翘曲问题。 由于刻蚀结构的表面形貌与刻蚀区域的线宽大小有很大关系,微小线宽结构刻蚀随着刻蚀深度的在增加,气体传输受到一定程度的限制,缺乏活性气体刻蚀导致能力减弱是制约小线宽高深宽比增大的主要因素。
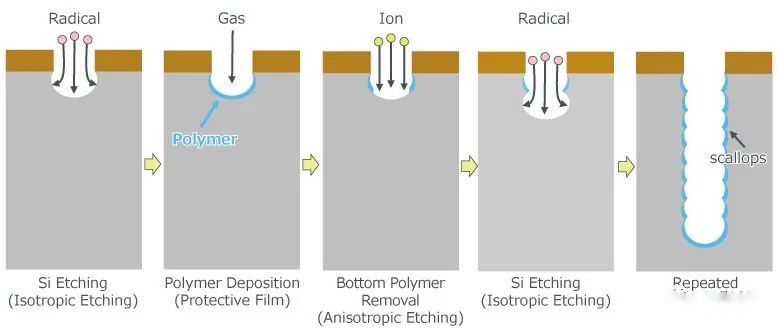
深反应离子刻蚀应用最普遍的是【Bosch工艺】,基于刻蚀和钝化交替进行,将一个刻蚀循环分解为三个子过程:碳氟聚合物沉积、钝化层刻蚀和硅的刻蚀,分别对应刻蚀菜单中Dep1,Etch1和Etch2。
为了改善刻蚀对深宽比的依赖性,在线圈功率和腔室压力不改变的情况下,逐渐增大Etch2子过程刻蚀时间,以及Etch1和Etch2两个刻蚀子过程中的极板功率,一方面增加反应气体,并为反应气体扩散和反应产物脱离提供了更多时间,另一方面提高极板功率能够提高等离子体的垂直角度和入射能量,加强等离子体垂直轰击能力,从而改善深沟槽底部的刻蚀情况。另一方面如果出现随着刻蚀深度增加开口尺寸增大,表明当前侧壁钝化层厚度不足以保护侧向不被刻蚀,需要增加Dep1或者减小Etch1。
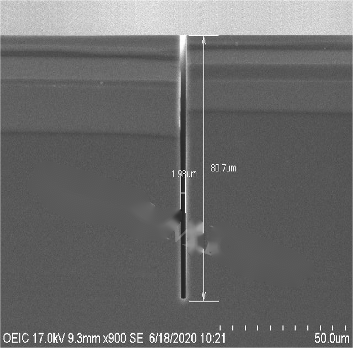
通过对工艺参数的优化,得到了下图为2μm线宽刻蚀深度80微米,深宽比达40:1。
 公安备案号:苏公网安备32059002006658号
公安备案号:苏公网安备32059002006658号
 微特云办公系统 微纳制造 MEMS设计
微特云办公系统 微纳制造 MEMS设计