
新闻
News
光刻的性能指标
点击量:1947 日期:2023-08-02 编辑:硅时代
1. 特征尺寸
特征尺寸又称为线宽(CD, critical dimension)。通常大家听到的7 nm制程、14 nm制程中的7nm和14nm指的便是芯片的线宽。线宽指的是在芯片生产过程中,能分辨的图形最小宽度,是衡量制程水平的主要指标。线宽越小,表明分辨率越高,工艺越先进。我们知道,光刻是将掩膜版上的条纹(pattern)复制到光刻胶上的过程。在复制过程中,受制程条件影响,线宽通常在一定范围内波动,需要通过设置一定的卡控条件保证线宽在可接受范围内。对于超过制程可接受范围的晶圆采取返工处理。
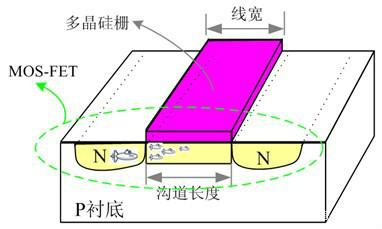
2. 线宽均匀性
在光刻制程中,光源经过掩膜版是会发生衍射,正负一阶光乃至高阶光中往往含有条纹信息,因此需要采用透镜汇聚衍射光。而为了保证光刻胶上进行成像,需要将晶圆放置于镜片焦距附近一定范围内(这个范围称为焦深,DOV),照相需要聚焦也是这个道理,否则成像模糊。线宽均匀性分为两类:曝光区域内(intra-field)的均匀性和曝光区域之间(inter field)的均匀性。
曝光区域内的线宽均匀性,主要是由掩膜版线宽均匀性(通过掩膜版误差因子传递)、能量的稳定性(在扫描时)、扫描狭缝内的照明均匀性、焦距(focus)/ 找平(leveling)对于曝光区域内每一点的均匀性、镜头的像差(如彗形像差、散光)、扫描的同步精度误差 (Moving Standard Deviation,MSD)等。曝光区域之间的线宽均匀性,主要是由照明能量的稳定性、硅片衬底膜厚的在硅片表面的分布均匀性(主要是由于涂胶均匀性、其他工艺带来的薄膜厚度均匀性)、硅片表面的平整度、显影相关烘焙的均匀性、显影液喷淋的均匀性等。

套刻误差是指光刻机的工作过程是这样的:逐一曝光完硅片上所有的场(field),亦即分步,然后更换硅片,直至曝光完所有的硅片;当对硅片进行工艺处理结束后,更换掩模,接着在硅片上曝光第二层图形,也就是进行重复曝光。其中,第二层掩模曝光的图形必须和第一层掩模曝光准确的套叠在一起,故称之为套刻。
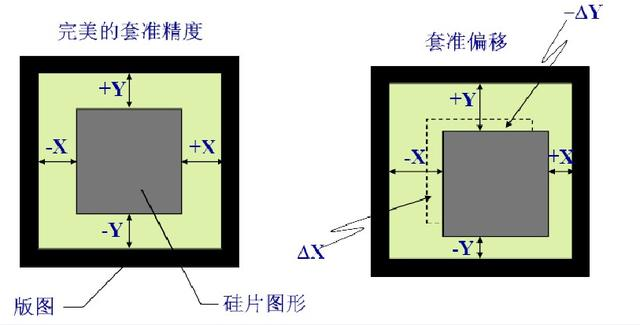
导致曝光图形与参考图形对准偏差原因很多。掩模变形或比例不正常、晶圆本身的变形、光刻机投影透镜系统的失真、晶圆工件台移动的不均匀等都会引入对准偏差。
 公安备案号:苏公网安备32059002006658号
公安备案号:苏公网安备32059002006658号
 微特云办公系统 微纳制造 MEMS设计
微特云办公系统 微纳制造 MEMS设计