
新闻
News
通用去胶方案
点击量:608 日期:2023-08-10 编辑:硅时代
在去胶发生困难的情况下(例如在密集的等离子蚀刻或溅射之后),超声或兆声清洗会对去除光刻胶带来很大的帮助。但是,在此过程中必须保护衬底上的敏感结构,否则将其破坏如下图1所示,所以我们建议这种带有高深宽比的结构的样品最好使用兆声辅助而不是超声辅助处理。由于溶解的光刻胶的含量增加,去胶剂随着长时间的发展其去胶效果在逐渐变弱。即使仍未达到理论上的饱和极限(远高于50%的固含量),使用过溶液会随着颗粒的富集并变得不透明,因此不再适合进行重复清洗。常见的做法是级联清洗。在此过程中,去除剂用于三个不同的清洗步骤。将样品放在第一个溶液池中,此步骤中几乎完全去除光刻胶残留物。然后将样品转移到第二个溶液池中,然后转移到第三个槽中,在最后一个步骤后用去离子水冲洗干净。一旦达到预定的溶解能力,就将第一个浴液丢弃,将第二个和第三个浴液向上移动一个位置。
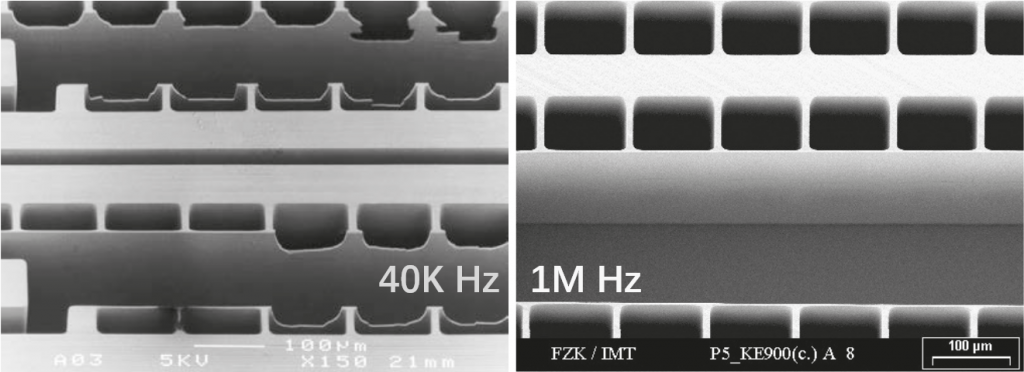
图1 LIGA工艺中使用超声40k Hz(左图)以及兆声1M Hz处理后的结构损坏情况
除此之外的功能还可以通过强氧化酸来实现,例如王水,食人鱼,硫酸或硝酸。这些酸用于最终清洁。但是除了环境保护方面(废酸的处理),这些混合物通常不仅侵蚀光刻胶,而且也会腐蚀衬底表面的其他材料。
在很多情况下,由于后续的工艺如过高的温度、长时间干法刻是、高剂量的离子注入后都会导致光刻胶膜的交联度太高或者光刻胶膜发生变性甚至碳化,从而无法利用湿法除光刻胶,这时候我们可以采用氧等离子去胶机进行去胶。 需要注意,市面上常见的等离子去胶机有射频和微波等离子去胶机两种。两者的本质区别是等离子的激发方式不一样,对应的反应方式也是有区别的,射频等离子去胶机除了氧等离子与碳氢化合物反应外,还伴随这比较重的离子轰击样品表面,会有一定的物理损伤,在光电子器件等对损伤敏感的应用中需要注意。另外,氧等离子体有可能会氧化衬底或者衬底表面的其他材料如铝膜等。
 公安备案号:苏公网安备32059002006658号
公安备案号:苏公网安备32059002006658号
 微特云办公系统 微纳制造 MEMS设计
微特云办公系统 微纳制造 MEMS设计