
新闻
News
离子注入与传统热扩散工艺区别
点击量:1679 日期:2023-08-18 编辑:硅时代
离子注入工艺是集成电路制造的主要工艺之一,它是指将离子束加速到一定能量(一般在keV 至Mev 量级范围内),然后注入固体材料表层内,以改变材料表层物理性质的工艺。在集成电路工艺中,固体材料通常是硅,而注入的杂质离子通常是硼离子、磷离子、砷离子、铟离子、锗离子等。注入的离子可改变固体材料表层电导率或形成 pn 结。当集成电路的特征尺寸缩小到亚微米时代后,离子注入工艺得到了广泛应用。
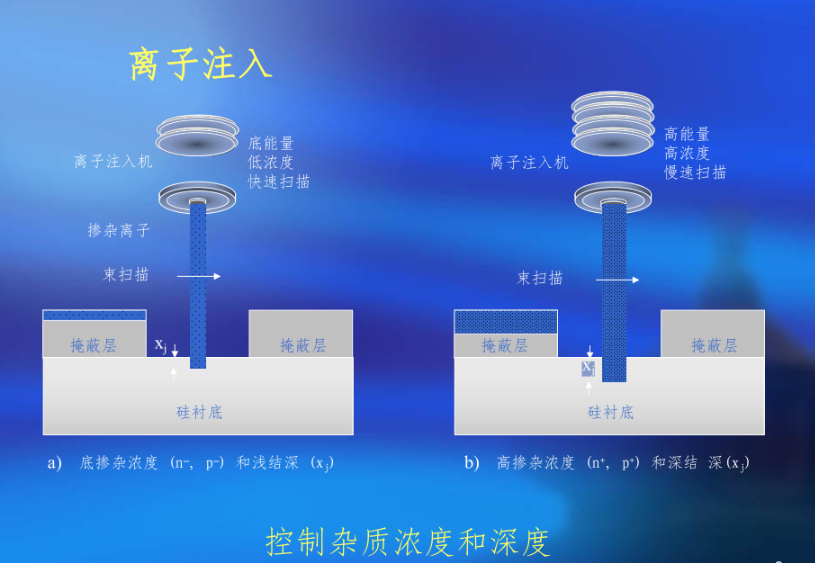
与通过传统热扩散工艺进行掺杂的方式相比,离子注入掺杂具有如下优点。
(1)通过调节注人的能量和剂量来改变注人离子的深度和浓度,可以获得对衬底内部比表面浓度更高的杂质离子分布,而这是扩散工艺无法实现的。
(2)进入衬底材料的入射离子虽然会因为碰撞发生很小的横向偏移,但总体来说可以按照掩膜图形在所需的位置获得掺杂,而且掩膜材科可以是包括光刻胶在内的任意半导体工艺常用的材料,非常有利于提高集成度。 (3)离子注入利用扫描的方法在圆片上顺次打入离子,突破扩散工艺中固溶度的限制,可以得到更高的浓度、更浅的结深、更均匀的分布。 在集成电路制造工艺中,离子注入通常应用于深埋层、倒掺杂井、阈值电压调节、源漏扩展注入、源漏注入、多晶硅栅掺杂、形成pn结和电阻/电容等。在绝缘体上硅(SOI)衬底材料制备工艺中,主要通过高浓度氧离子注入的方法来形成埋氧层,或者通过高浓度氢离子注入的方法来实现智能切割(Smart Cut)。离子注入是通过离子注入机来完成的,其最重要的工艺参数是剂量和能量:剂量决定了最终的浓度,而能量决定了离子的射程 (即深度)。根据器件设计需求的不同,注入的条件分为大剂量高能量、中剂量中能量、中剂量低能量或大剂量低能量等。为了获得理想的注入效果,针对不同的工艺要求,应配备不同的注入机。离子注入后,一般要经过高温退火过程,用以修复离子注入导致的晶格损伤,同时激活杂质离子。在传统集成电路工艺中,虽然退火温度对掺杂有很大影响,但离子注入工艺本身的温度并不关键。在14nm 以下技术节点,某些离子注入工艺需在低温或高温的环境下进行,这样可以改变晶格损伤等的影响。
 公安备案号:苏公网安备32059002006658号
公安备案号:苏公网安备32059002006658号
 微特云办公系统 微纳制造 MEMS设计
微特云办公系统 微纳制造 MEMS设计