
新闻
News
【MEMS工艺】双重曝光 (DE)工艺流程详解
点击量:3228 日期:2025-01-22 编辑:硅时代
双重曝光(Double Exposure, DE)技术,作为半导体制造领域的一项精密工艺,其核心在于在同一层光刻胶上巧妙地实施两次独立的曝光操作,每次曝光采用不同的掩模版。这一技术巧妙地利用了光刻胶对光强的累积效应,通过两次曝光光强的叠加,创造出所需的精细图形。这一过程不仅要求高度的工艺精确性,还体现了半导体制造中对微细加工技术的极致追求。
具体而言,双重曝光工艺流程始于光刻胶的旋涂,即在清洁的晶片表面均匀涂覆一层光刻胶。随后,进行第一次曝光,此时使用的掩模版上设计有特定的图案,光线通过这些图案投射到光刻胶上,形成初次曝光区域。紧接着,在不移除光刻胶的情况下,使用另一块具有相同或相似图案但位置有所偏移的掩模版进行第二次曝光。两次曝光均在相同的光刻胶层上进行,但图案的相对位置变化使得在光刻胶内部形成了复杂的曝光强度分布。
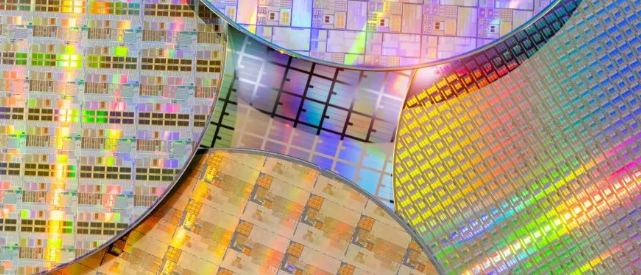
曝光完成后,晶片需经过烘烤步骤,以加强光刻胶对曝光光强的响应,并促进后续显影过程中的化学变化。烘烤之后,进行显影,光刻胶中曝光强度达到或超过特定阈值的区域将被溶解去除,而未曝光或曝光不足的区域则保留下来,形成与掩模版图案相对应的图形。最后,通过刻蚀步骤,将光刻胶上的图形转移到晶片下方的材料层上,完成整个双重曝光工艺流程,简写为litho-litho-etch (LLE)。
双重曝光技术的一个典型应用案例是制造50nm线宽的1:1线条。在这一案例中,第一次曝光利用周期为200nm的掩模版,形成一系列间隔均匀的沟槽。第二次曝光时,使用与第一次相同的图案,但整体向某一方向移动100nm,这样,原本间隔的沟槽在重叠区域形成了连续的50nm线条。经过烘烤和显影后,这些线条得以精确呈现,形成致密的50nm/50nm图形。这一方案的优势在于,每次曝光只需分辨较大的200nm周期图案,降低了单次曝光的难度,同时,每次曝光的照明条件可以针对掩模图形进行优化,提高了工艺灵活性和精度。此外,由于两次曝光在同一光刻胶层上进行,无需额外的光刻胶涂覆步骤,简化了工艺流程。更重要的是,由于两次曝光之间晶圆在工件台上保持固定,对准误差得以有效控制,确保了图形的精确叠加。
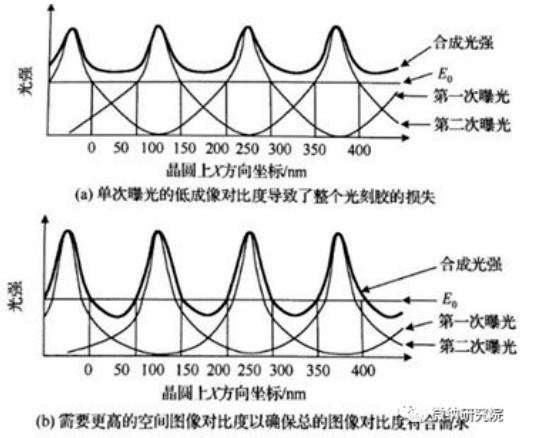
然而,双重曝光技术并非无懈可击。在实际操作中,若两次曝光成像的空间对比度不足,或散射光(flare)过于强烈,可能导致非曝光区域接收到的总光强超过光刻胶的脱保护阈值E0,引起不必要的曝光,进而导致整个光刻胶层在显影过程中被完全去除。为了避免这种情况,曝光系统必须提供高空间图像对比度,确保曝光区域与非曝光区域之间有明确的界限。此外,光刻胶对曝光能量的反应需具有高度非线性,即曝光能量低于某一特定值时,光刻胶几乎不发生损耗,这种特性有助于减少非曝光区域的意外曝光风险。
光学曝光作为双重曝光技术的核心环节,其重要性不言而喻。曝光过程中,光源发出的光线首先通过精确对准的掩模版,掩模版上的不透明和透明区域共同构成了要转移到硅片表面的图形。曝光的目的在于将掩模版上的图形精确复制(在规范之内)到光刻胶上,形成最终图像。在这一过程中,曝光光线的波长起着至关重要的作用。波长越短,能够曝出的特征尺寸就越小,这是推动硅片上特征尺寸缩小的关键因素。同时,曝光光线产生的能量对光刻胶的光化学反应至关重要,它触发了光刻胶从可溶到不可溶或从不可溶到可溶的化学状态转变。为了确保曝光质量,光线必须均匀分配到整个曝光区域,避免局部曝光不足或过度。
为了获得当今精细光刻的关键尺寸,必须在更短的波长下进行更强曝光。这要求曝光系统具备更高的分辨率和更精确的对准能力,同时,光刻胶材料也需要不断改进,以适应更高强度的曝光和更复杂的曝光模式。双重曝光技术,作为应对这些挑战的有效手段之一,正不断推动着半导体制造技术的边界,为更小、更快、更智能的电子设备的诞生奠定了坚实基础。
 公安备案号:苏公网安备32059002006658号
公安备案号:苏公网安备32059002006658号
 微特云办公系统 微纳制造 MEMS设计
微特云办公系统 微纳制造 MEMS设计