电话:15301560529

新闻
News
【MEMS工艺】一文读懂湿法刻蚀工艺
点击量:4061 日期:2025-02-17 编辑:硅时代
一、湿法刻蚀工艺概述
湿法刻蚀通过化学试剂选择性溶解材料,实现微纳结构的精准成型。其核心在于化学反应控制(选择性、速率、均匀性)与材料兼容性。与干法刻蚀(等离子体)相比,湿法刻蚀具有成本低、通量高、设备简单等优势,但受限于各向同性刻蚀特性,适用于精度要求适中的场景。
二、湿法刻蚀工艺步骤详解
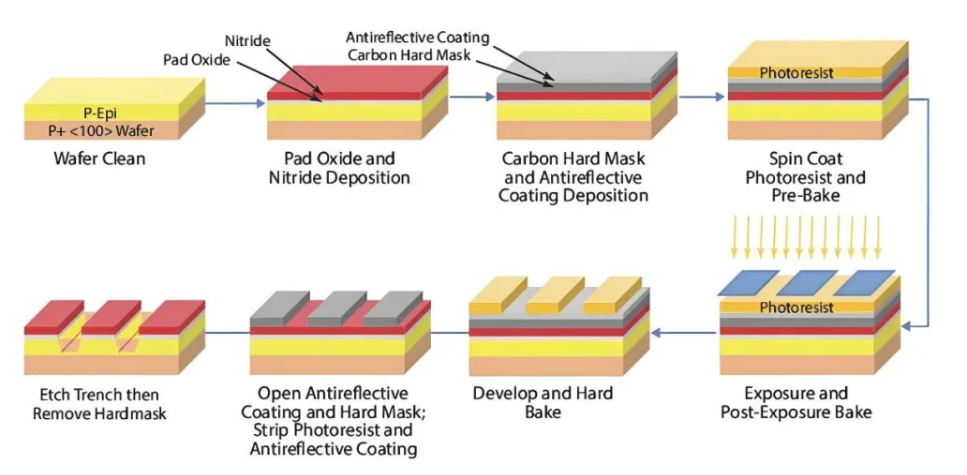
1. 准备阶段
二氧化硅(SiO₂):氢氟酸缓冲液(BHF: HF + NH₄F)
单晶硅:KOH各向异性刻蚀(54.7°斜面角)
金属铝:磷酸/硝酸/醋酸混合液(H₃PO₄:HNO₃:CH₃COOH=16:1:1)
有机溶剂剥离(丙酮超声)
氧等离子体灰化(适用于耐溶剂结构)
高温热解(>400℃,可能影响底层材料)
 公安备案号:苏公网安备32059002006658号
公安备案号:苏公网安备32059002006658号
 微特云办公系统 微纳制造 MEMS设计
微特云办公系统 微纳制造 MEMS设计